
微信咨询
氧化工艺的简介
在集成电路制造工艺中,氧化硅薄膜形成的方法有热氧化和沉积两种,氧化工艺是指用热氧化方法在硅表面形成SiO2的过程。
氧化工艺分干氧氧化和湿氧氧化两种。
干氧氧化,以干燥纯净的氧气作为氧化气氛,在高温下(一般在1000℃左右进行)直接与硅发生化学反应。
干氧氧化的速率比湿氧氧化低,通常干氧氧化的时间长达2小时,湿氧氧化的时间缩短至12分钟左右,
但氧化薄膜质量比湿氧氧化高,所以厚度较薄的屏蔽氧化层、衬底氧化层和栅氧化层的生长一般用干氧氧化。
优点:SiO2氧化层结构致密,厚度均匀,重复性好,与光刻胶的黏附性好且应力小
缺点:生长温度高,生长速度慢
湿氧氧化是用水取代氧气,在高温下水分解为HO,HO在二氧化硅中的扩散速率比干氧氧化高。
湿氧氧化用于生长较厚的氧化层如遮蔽氧化层、整面全区覆盖氧化层和LOCOS氧化层等。干氧氧化与湿氧氧化常见的原理如下:
干氧氧化
Si(s)+O2(V)—>SiO2(s) 900-1200℃
湿氧氧化
Si(s)+H2O(v)—>SiO2(s)+H2(v) 900-1200℃
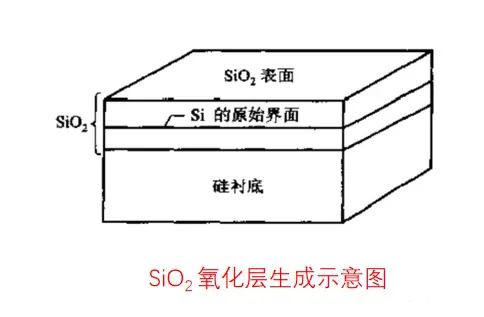
湿氧气氧化
湿氧氧化法中,O2先通过95-98℃的去离子水(DIW),将水汽一起带入氧化炉内,O2和水汽同时与Si发生氧化反应。采用这种氧化方法生成的SiO2膜的质量比干氧化法的略差,但远好过水汽氧化的效果,而且生长速度较快,因此。当所需氧化层厚度很厚且对氧化层的电学性能要求不高的情形下,为了产能的考虑,常采用这种方法。
其缺点是生成的SiO2膜与光刻胶的附着性不良、Si表面存在较多位错缺陷。
在实际的制造工艺中,通常采用干氧→湿氧→干氧这种多步交替的氧化方法制备氧化层,这样,既能保证SiO2膜质量,又能有较快的氧化速率。
版权所有 ©2023 青岛华旗科技有限公司鲁ICP备18050447号-1